福州大學李悌濤、張海忠團隊聯合上海光機所齊紅基研究員-通過MOCVD原位氮摻雜實現高空穴濃度p型Ga?O?
由福州大學李悌濤副教授、張海忠教授團隊聯合上海光機所齊紅基研究員團隊在學術期刊 The Journal of Physical Chemistry Letters 發布了一篇名為Insight into the High Hole Concentration of p-Type Ga2O3 via In Situ Nitrogen Doping(原位氮摻雜誘導 p 型 Ga2O3 高空穴濃度的機理研究)的文章。福州大學博士研究生盧耀平為論文第一作者。
1. 項目支持
本研究得到了國家自然科學基金(No. 62204270)、福建省重大科技專項(No. 2022HZ027006)、福建省自然科學基金(No. 2024J01251,2022I0006)和泉州市重大科技專項(No. 2022GZ7)的資助。作者感謝在外延薄膜的生長過程中得到了杭州富加鎵業科技有限公司的幫助。
2. 背景
氧化鎵(Ga2O3)因其超寬帶隙和高Baliga優值,在電力電子器件領域潛力巨大,然而缺乏可靠的 p 型 Ga2O3 材料是限制其在超高耐壓功率器件中進一步應用的主要瓶頸。現有實現 p 型的方法,如 p-NiO 的替代、GaN 熱氧化、離子注入(P, N)、H2 氣氛退火等,可能分別存在著穩定性較差、工藝兼容性不足、晶格損傷嚴重、施主補償效應或難以精確控制等局限性。研究團隊認識到,在 Ga2O3 中要形成可靠的 p 型導電性,必須要求在材料的晶體質量足夠高的前提下,由缺陷或非故意摻雜所引入的施主補償效應被抑制到足夠低水平,才能使受主型雜質占主導地位。考慮到氮(N)和氧(O)有著相近的離子半徑,且 N-Ga 鍵較強,如果能夠通過仔細調控 N 摻雜的熱力學條件,使得在 Ga2O3 晶格中實現大部分 N 替位 O,是有望制備出具有低晶格畸變、高空穴濃度的 p 型 Ga2O3。而在同質外延體系中進行 N 原位摻雜,則是制備以上“半導體級” p 型 Ga2O3 的一種理想方法。
3. 主要內容
p 型導電機制不明晰以及缺乏可靠的 p 型 Ga2O3 材料,嚴重阻礙了Ga2O3 基超高耐壓功率器件的發展。在此,研究團隊通過金屬有機化學氣相沉積(MOCVD)技術的同質外延方法進行 N 的原位摻雜,創新性提出了使用笑氣(N2O)作為氧源和 N 受主摻雜劑。結構及元素定量分析結果表明 N 的有效摻入(得益于強 N–Ga 鍵),補償了殘余的硅和氫施主,同時未顯著犧牲晶體質量。Ga2O3:N 外延層顯示出了出色的 p 型導電性:室溫下空穴濃度為 1.04 × 1018 cm–3,遷移率為 0.47 cm2 V–1 s–1,激活能為 0.168 eV。
研究團隊從晶體學視角對 Ga2O3 中的 p 型導電機制給出了具象化的解析,重點在于受主(N2–)和空穴(O?)的具象化,以及空穴激發的化學反應過程(N2- + O2- → N3- + O-)。這一具象化描述確切指出了在 p 型 Ga2O3 中受主和空穴的“組件單元”,意味著如果要制備 p 型 Ga2O3,就要制備出微量(1015 cm-3~1019 cm-3)固溶于 O2-(1022 cm-3)晶格中的 O-。而一旦在整個由 O2- 組成的 Ga2O3 晶格中出現了 O?,意味著相應的局域晶格上出現了自由的凈“正電荷”(即空穴),即實現了 Ga2O3 的 p 型導電。研究結果表明,仔細抑制施主補償效應以及精確控制氮的化學勢,從而在 Ga2O3 中形成微量的 O? 固溶體,對于實現氧化物中的高空穴濃度 p 型導電至關重要。
4.創新點
首次通過 MOCVD 同質外延和原位N 摻雜方法成功制備出具有 1018 cm–3 室溫高空穴濃度的 p 型 β-Ga2O3,并發現了 N 在 Ga2O3 中表現出淺受主特性,有別于傳統認為的深受主行為。
創新性地采用 N2O 同時作為氧源和氮摻雜源,有效解決了傳統維持高結晶質量(需高溫環境)與實現高濃度氮摻雜(僅可在低溫實現)的固有矛盾。
從晶體學視角揭示了全新 p 型導電機制,通過受主(N2-)-空穴(O-)等"組成單元"的具象化解析,闡明了 p 型 Ga2O3 中室溫下受主激發過程(N2- + O2- → N3- + O-)的機理。
5. 總結
研究團隊提出了一種通過 MOCVD 同質外延實現原位氮摻雜以獲得高空穴濃度 p 型 Ga2O3 的策略。利用 N−Ga 鍵的高鍵能(與 O−Ga 鍵能相當)并保持二維臺階流生長,通過精細調控熱力學條件成功地將 Ga2O3:N 的電學性質從 n 型調至 p 型。首次實現了高達 1.04×1018 cm−3 的室溫空穴濃度和 0.47 cm2 V−1 s−1 的空穴遷移率,同時具有 0.168 eV 的淺受主激活能。結果表明,氮受主雜質可以在高溫下以高濃度摻入 Ga2O3 晶格并取代氧位點。此外,還對 Ga2O3:N 中的 p 型導電機制進行了全新的晶體學解析,揭示了 p 型導電氧化物中受主(N2−)和空穴(O−)的性質,以及淺能級受主激活的化學反應過程(N2− + O2− → N3− + O−)。建議為成功制備半導體級的 p 型 Ga2O3,必須嚴格控制由缺陷或無意摻雜雜質引起的施主補償效應至足夠低的水平,才能使受主型 NO 缺陷占主導地位,從而最終獲得少量的 O− 離子穩定地固溶于 Ga2O3 晶格中。這項工作為 p 型 Ga2O3 在高壓功率器件中的應用提供了一條潛在途徑。
6. 圖文示例

圖 1. 通過原位 N 摻雜實現 p 型 Ga2O3 的策略。(a) 基于同質外延法制備 p 型 Ga2O3 的 MOCVD 反應室示意圖。作為反應物的 TMGa 和 N2O 以垂直耦合噴淋式從勻氣盤進入反應室,發生 TMGa + N2O → (Ga2O3)1-δ(Ga2NO2)δ (δ 的范圍為10-6 至10-3)的反應,最終在半絕緣 Ga2O3:Fe 基底上制備出 p 型 Ga2O3:N 外延層。插圖為 (001) 面 Ga2O3:Fe 襯底和 Ga2O3:N 外延層的照片。(b) Ga2O3:N 晶格示意圖,其中 N 主要取代 OIII 位點,N-Ga 的鍵能為 348 ± 35 kJ mol-1,O-Ga 的鍵能為 374 ± 21 kJ mol-1。 (c) MOCVD 同層外延過程中在 Ga2O3 晶格中原位摻入 N 的示意圖。高生長溫度下的 N2O 分解產生了高 N 化學勢。高溫下的高擴散系數促使原子向以平臺-臺階-節點(TSK)為模型的臺階或節點處遷移,從而實現了二維臺階流生長。橙色圓圈代表 N 原子通過強 N-Ga 鍵與 Ga 緊密連接的狀態。由于 N 和 O 的離子半徑相似,因此晶格畸變很小。

圖 2. HD-Ga2O3:N同質外延層的電學表征結果。(a) 沉積于?001?取向 Ga2O3:Fe 半絕緣襯底上的同質外延樣品的霍爾電學測量示意圖。(b) HD-Ga2O3:N 樣品在 300 K 時四電極間歐姆接觸特性測試結果。測量值(散點)與擬合的理想歐姆模型(曲線)高度吻合。(c) 300~350 K 溫度范圍內(電極1-2間)歐姆接觸測試結果。(d) 磁場依賴的霍爾電壓測量結果。(e) 空穴濃度隨溫度的變化規律,300K 時為 1.04×1018 cm−3。基于 Arrhenius 方程擬合得到 0.165 eV 受主激活能。(f) HD-Ga2O3:N同質外延層的空穴遷移率的溫度依賴特性,300K 時為 0.47 cm2 V−1 s−1 。
表1: (001) 面 N 摻雜 Ga2O3 同質外延層導電特性隨生長溫度的變化
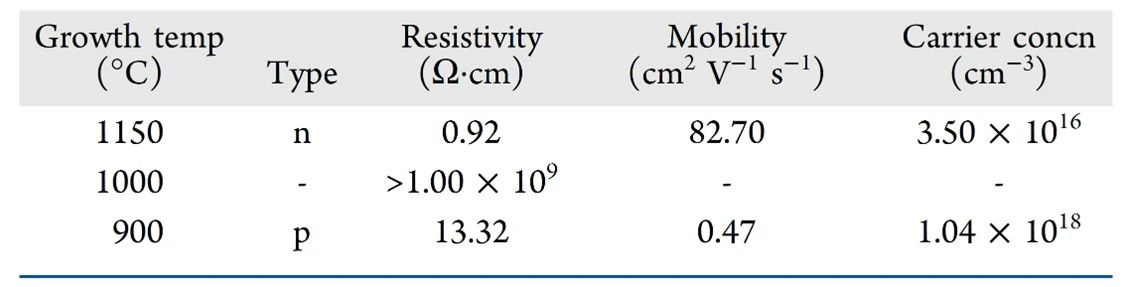
DOI:
doi.org/10.1021/acs.jpclett.5c00318
本文轉發自《亞洲氧化鎵聯盟》訂閱號
